Диоды ганна общие сведения диод ганна. Диод ганна
В качестве материала структуры используется обычно арсенид галлия (GaAs) n-типа, возможно применение фосфида индия (InP). Отрицательное дифференциальное сопротивление диода Ганна является следствием эффекта междолинного переноса электронов, характерного для многодолинных полупроводников, имеющих в зоне проводимости несколько областей (долин).
На рис.3.16 изображена зонная диаграмма арсенида галлия n-типа (n-GaAs) - основного материала, используемого для изготовления ДГ. Электроны в зоне проводимости могут находится в одной из долин, разделенных энергетическим зазором ∆= 0,36 эВ. Электроны, находящиеся в нижней долине, обладают малой эффективной массой m 1 * = 0,07m o , где m о = 9,1×10 -31 кг - масса свободного электрона, и большой подвижностью m 1 = V/Е, находящиеся же в верхней долине имеют значительно большую эффективную массу m 2 * = 1,2m o и как следствие - значительно меньшую подвижность.
В
состоянии термодинамического равновесия,
т.е. в отсутствии внешнего воздействия,
концентрация электронов n 1
и n 2
в нижней и верхней долинах подчиняются
закону Больцмана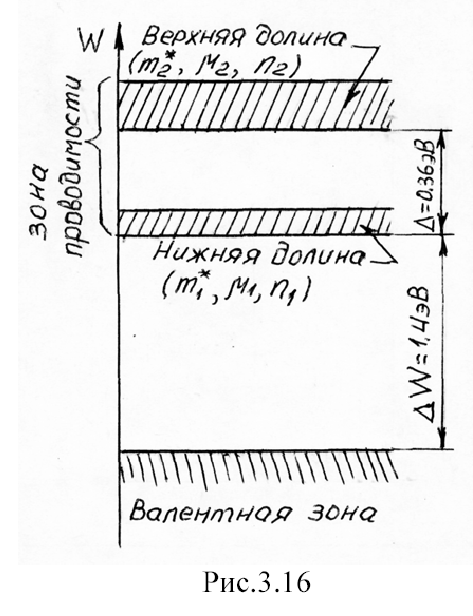
n 1 /n 2 =A e -∆/(kT) , (3.16) где k = 1,38×10-23 Дж/град - постоянная Больцмана, А = N 1 /N 2 , (A=70 для GaAs), N 1 , N 2 - плотности энергетических состояний в долинах.
При комнатной температуре Т = 300 К согласно (3.16) n 2 /n 1 = 7×10 -5 , т.е. практически все электроны зоны проводимости находятся в нижней долине. Положение меняется при прикладывании к диоду напряжения Uо. С увеличением U0 возрастает напряженность электрического поля Е =U0/L (L – длина активной области диода) и энергия электронов, что эквивалентно возрастанию температуры Т. В результате возрастает число электронов
проводимости, переходящих из нижней долины в верхнюю.
Средняя дрейфовая скорость электронов при любом значении Е определяется как средняя арифметическая скорость электронов нижней (V1) и
верхней (V2) долин
График зависимости скорости электронов от напряженности электрического поля V(Е) для n-GaAs приведен на рис.3.17. При Е < Епор почти все электроны зоны проводимости находятся в нижней долине n = n1 + n2 = n1, n=0 . Согласно (3.17) V = µE, т.е. зависимость V(Е) имеет линейный характер.
С
увеличнием напряжености поля Е все
большее число электронов переходит в
верхнюю долину (n2 - возрастает, n1 -
уменьшается), при Е > Епор этот процесс
происходит настолько резко, что происходит
уменьшение средней дрейфовой скорости
электронов V. Напряженность поля,
соответствующая максимальной скорости
Vмакс, называют пороговой (или критической)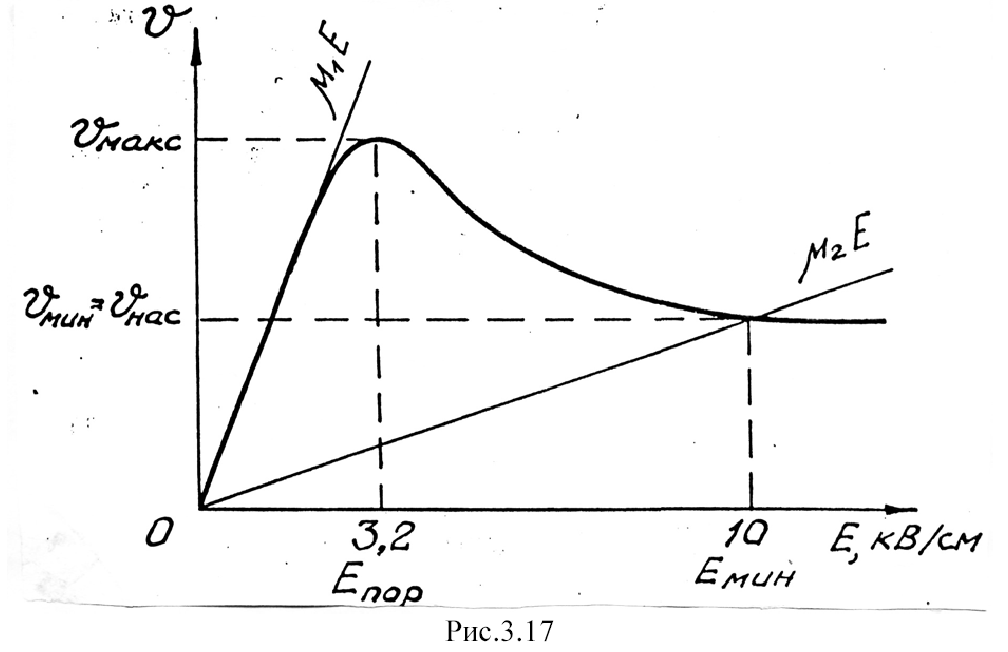
Из (3.17) следует, что при Е > Eпор, когда n2=n и n1=0, зависимость V(Е) снова должна стать линейной: V = µ 2 E. В действительности при сильных полях Е > Eпор взаимодействие электронов с кристаллической решеткой приводит к насыщению скорости электронов, поэтому V = Vнас = const. Крутизну падающего участка зависимости V(Е) характеризуют дифференциальной подвижностью
µ3 = dV/dE < 0, (3.18)
Плотность электронного тока в однородном полупроводнике пропорциональна средней дрейфовой скорости электронов:
j = GE = e(µ1n1 + µ2n2)E = e(n1 + n2)V, (3.19)
где G- удельная проводимость полупроводника.
При n0 = n1 + n2 = const во всем объеме полупроводника уменьшение скорости электронов с увеличением напряженности поля (dV/dЕ < 0) равносильно уменьшению плотности тока (dj/dE < 0) и следовательно является причиной возникновения в полупроводнике состояния отрицательной дифференциальной проводимости (G < 0).
Полупроводник, обладающий отрицательной дифференциальной проводимостью имеет следующее свойство: если в объеме кристалла полупроводника возникает произвольная флуктуация концентрации носителей заряда ∆n, избыточная по отношению равновесной концентрации и no, то в той области кристалла, где возникла эта флукциация, начнется нарастание пространственного заряда в пространстве и во времени, что приведет к
неустойчивости распределения электрического поля в кристалле при постоянном приложенном напряжении
U > Uпор = Епор×L.
Для более подробного рассмотрения этого свойства обратимся к рис.3.18, который иллюстрирует развитие неустойчивости электрического поля в однородном полупроводнике, обладающем отрицательной дифференциальной проводимостью. Предположим, что при приложении к ДГ напряжения Uo из катода в однородный полупроводник инжектируются электроны, в результате чего в пределах небольшого участка х возникает неоднородность, в виде слоя накопления, в которой количество электронов n > no (рис. 3.18,а). Распределение поля Е(х) связано с распределением заряда n(x) - no уравнением Пуассона:

![]() ,
где
ε - диэлектрическая проницаемость.
,
где
ε - диэлектрическая проницаемость.
Там, где n = n 0 ∂E/∂x = 0 и поэтому Е = const. В области же, где n > no, ∂E/∂x > 0, т.е. напряженность поля Е(х) возрастает.
Поскольку напряжение U=, а в области неоднородности ∂E/∂x > 0 напряженности поля Е1 и Е2 окажутся разными: Е1 < Eср = U/L < E2. Если Еср соответствует падающему участку (рис.3.18,в), скорость электронов V1(E1) > V2(E2), заряд движущегося к аноду слоя будет пополняться за счет электронов, поступающих со стороны катода.Увеличение же заряда приведет к увеличению ∂E/∂x в слое и как следствие, к увеличению разности полей Е2 - Е1 (рис.3.18,б). Рост Е2 и уменьшение Е1 будут продолжаться до тех пор, пока растущий слой объемного заряда не исчезнет, достигнув анодного контакта. Затем процесс накопления, перемещения растущего заряда и его рассасывания будет периодически повторяться, причем период равен времени движения заряда через кристалл Т = L/Vнас. При этом будут наблюдаться периодические колебания тока во внешней цепи диода Ганна. В зависимости от длины активной области диода L, концентрации носителей n возможны и другие виды неустойчивости тока в образце GaAs при постоянном приложенном напряжении Uo. Явление возникновения колебаний тока в однородном образце n-GaAs часто называется эффектом Ганна.
Использующийся для генерации и преобразования колебаний в диапазоне СВЧ на частотах от 0,1 до 100 ГГц. В отличие от других типов диодов, принцип действия диода Ганна основан не на свойствах p-n-переходов , т.е. все его свойства определяются не эффектами, которые возникают в местах соединения двух различных полупроводников, а собственными свойствами применяемого полупроводникового материала.
В отечественной литературе диоды Ганна называли приборами с объемной неустойчивостью или с междолинным переносом электронов, так как активные свойства диодов обусловлены переходом электронов из "центральной" энергетической долины в "боковую", где они уже могут характеризоваться малой подвижностью и большой эффективной массой. В иностранной же литературе диоду Ганна соответствует термин ТЭД (Transferred Electron Device).
На основе эффекта Ганна созданы генераторные и усилительные диоды, применяемые в качестве генераторов накачки в параметрических усилителях, гетеродинов в супергетеродинных приемниках, генераторов в маломощных передатчиках и в измерительной технике.
При создании низкоомных омических контактов, необходимых для работы диодов Ганна, существуют два подхода.
- Первый из них заключается в поисках приемлемой технологии нанесения таких контактов непосредственно на высокоомный арсенид галлия.
- Второй подход заключается в изготовлении многослойной конструкции генератора. В диодах такой структуры на слой сравнительно высокоомного арсенида галлия, служащего рабочей частью генератора, наращивают с двух сторон эпитаксиальные слои относительно низкоомного арсенида галлия с электропроводностью n-типа. Эти высоколегированные слои служат переходными прослойками от рабочей части прибора к металлическим электродам.
Диод Ганна традиционно состоит из слоя арсенида галлия с омическими контактами с обеих сторон. Активная часть диода Ганна обычно имеет длину порядка l = 1-100 мкм и концентрацию легирующих донорных примесей n = 10 14 − 10 16 см −3 . В этом материале в зоне проводимости имеются два минимума энергии, которым соответствуют два состояния электронов - «тяжёлые» и «лёгкие». В связи с этим с ростом напряжённости электрического поля средняя дрейфовая скорость электронов увеличивается до достижения полем некоторого критического значения, а затем уменьшается, стремясь к скорости насыщения.
Таким образом, если к диоду приложено напряжение, превышающее произведение критической напряжённости поля на толщину слоя арсенида галлия в диоде, равномерное распределение напряжённости по толщине слоя становится неустойчиво. Тогда при возникновении даже в тонкой области небольшого увеличения напряжённости поля электроны, расположенные ближе к аноду , «отступят» от этой области к нему, а электроны, расположенные у катода , будут пытаться «догнать» получившийся движущийся к аноду двойной слой зарядов. При движении напряжённость поля в этом слое будет непрерывно возрастать, а вне его - снижаться, пока не достигнет равновесного значения. Такой движущийся двойной слой зарядов с высокой напряжённостью электрического поля внутри получил название домена сильного поля, а напряжение, при котором он возникает - порогового.
В момент зарождения домена ток в диоде максимален. По мере формирования домена он уменьшается и достигает своего минимума по окончании формирования. Достигая анода, домен разрушается, и ток снова возрастает. Но едва он достигнет максимума, у катода формируется новый домен. Частота, с которой этот процесс повторяется, обратно пропорциональна толщине слоя полупроводника и называется пролетной частотой.
На ВАХ полупроводникового прибора наличие падающего участка является не достаточным условием для возникновения в нём СВЧ колебаний, но необходимым. Наличие колебаний означает, что в пространстве кристалла полупроводника возникает неустойчивость волновых возмущений. Но такая неустойчивость зависит от параметров полупроводника (профиля легирования, размеров, концентрации носителей и т.д.).
При помещении диода Ганна в резонатор возможны другие режимы генерации, при которых частота колебаний может быть сделана как ниже, так и выше пролетной частоты. Эффективность такого генератора относительно высока, но максимальная мощность не превышает 200-300мВт.
Диод Ганна может быть использован для создания генератора в 10 ГГц и выше (ТГц) диапазона частот. А резонатор, который может принимать форму волновода, добавляют для контроля частоты.Частота генераторов на диоде Ганна определяется в основном резонансной частотой колебательной системы с учетом емкостной проводимости диода и может перестраиваться в широких пределах механическими и электрическими методами. Однако срок службы генераторов Ганна относительно мал,что связано с одновременным воздействием на кристалл полупроводника таких факторов, как сильное электрическое поле и перегрев кристалла из-за выделяющейся в нем мощности.
Диоды Ганна, работающие в различных режимах, используются в диапазоне частот 1-100 ГГц. В непрерывном режиме реальные генераторы на диодах Ганна имеют КПД порядка 2-4% и могут обеспечить выходную мощность от единиц мВт до единиц Вт. Но при переходе в импульсный режим КПД увеличивается в 2-3 раза. Специальные резонансные системы, позволяющие добавить к мощности полезного выходного сигнала некоторые высшие гармоники, служат для увеличения КПД и такой режим называется релаксационным.
Существуют несколько разных режимов, в одном из которых генератор на диоде Ганна может совершать работу, в зависимости от питающего напряжения, температуры, свойства нагрузки: доменный режим, гибридный режим, режим ограниченного накопления объемного заряда и режим отрицательной проводимости.
Наиболее часто используемым режимом является доменный режим, для которого в течение значительной части периода колебаний, характерен режим существования дипольного домена. Доменный режим может иметь три различных вида: пролетный, с задержкой образования доменов и с гашением доменов, которые получаются при изменении сопротивления нагрузки.
Для диодов Ганна был так же придуман и осуществлен режим ограничения и накопления объемного заряда. Его существование имеет место, при больших амплитудах напряжения на частотах, в несколько раз больше пролетной частоты и при постоянных напряжениях на диоде, которые в несколько раз превышают пороговое значение. Однако существуют требования для реализации к данному режиму: нужны диоды с очень однородным профилем легирования.Однородное распределение электрического поля и концентрации электронов по длине образца обеспечивается за счет большой скорости изменения напряжения на диоде.
Наряду с арсенидом галлия и фосфидом индия InP (до 170 ГГц) методом эпитаксиального наращивания, для изготовления диодов Ганна также используетсяи нитрид галлия (GaN) на котором и была достигнута наиболее высокая частота колебаний в диодах Ганна - 3 ТГц. Диод Ганна имеет низкий уровень амплитудных шумов и низкое рабочее напряжение питания (от единиц до десятков В).
Эксплуатация диодов происходит в резонансных камерах представляющие собой в виде микросхем на диэлектрических подложках с резонирующими емкостными и индуктивными элементами, либо в виде комбинации резонаторов с микросхемами.
Энциклопедичный YouTube
-
1 / 5
Просмотров:
8.1. Общие сведения
Диод Ганна – полупроводниковый диод, состоящий из однородного полупроводника, генерирующий СВЧ колебания при приложении постоянного электрического поля.Физической основой, позволяющей реализовать такие свойства в диоде, является эффект Ганна , который заключается в генерации высокочастотных колебаний электрического тока в однородном полупроводнике с N образной вольт амперной характеристикой.
Эффект Ганна обнаружен американским физиком Дж. Ганном (J. Gunn) в 1963 г. в кристалле арсенида галлия (GaAs) с электронной проводимостью. Ганн обнаружил, что при приложении электрического поля E
(E
пор ≥
2 3 кВ/см) к однородным образцам из арсенида галлия n
типа в образце возникают спонтанные колебания тока. Позднее он установил, что при E
>
E
пор в образце, обычно у катода, возникает небольшой участок сильного поля – «домен», дрейфующий от катода к аноду со скоростью ~10 7 см/сек и исчезающий на аноде. Затем у катода формируется новый домен, и процесс периодически повторяется. Моменту возникновения домена соответствует падение тока, текущего через образец. Моменту исчезновения домена у анода – восстановление прежней величины тока. Период колебаний тока приблизительно равен пролетному времени, т.е. времени, за которое домен дрейфует от катода к аноду.
8.2. Требования к зонной структуре полупроводников
Эффект Ганна наблюдается главным образом в двухдолинных полупроводниках, зона проводимости которых состоит из одной нижней долины и нескольких верхних долин .Для того, чтобы при переходе электронов между долинами возникало отрицательное дифференциальное сопротивление, должны выполняться следующие требования:
средняя тепловая энергия электронов должна быть значительно меньше энергетического зазора между побочной и нижней долинами зоны проводимости, чтобы при отсутствии приложенного внешнего электрического поля бόльшая часть электронов находилась в нижней долине зоны проводимости;
эффективные массы и подвижности электронов в нижней и верхних долинах должны быть различны. Электроны нижней долины должны иметь высокую подвижность μ 1 , малую эффективную массу m 1 * и низкую плотность состояний. В верхних побочных долинах электроны должны иметь низкую подвижность μ 2 , большую эффективную массу m 2 * и высокую плотность состояний;
энергетический зазор между долинами должен быть меньше, чем ширина запрещенной зоны полупроводника, чтобы лавинный пробой не наступал до перехода электронов в верхние долины.
Из изученных и применяемых полупроводниковых материалов перечисленным требованиям наиболее соответствует арсенид галлия n типа.
Рассмотрим междолинный переход электронов в арсениде галлия. Приложим к однородному образцу из арсенида галлия электрическое поле. Если напряженность поля в образце мала, то все электроны находятся в нижней долине зоны проводимости (в центре зоны Бриллюэна). Поскольку средняя тепловая энергия электронов значительно меньше энергетического зазора между дном верхней и нижней долин зоны проводимости, они не переходят в верхнюю долину (рис. 8.1).
Рис. 8.1. Схематическая диаграмма, показывающая энергию электрона в зависимости от волнового числа в области минимумов зоны проводимости арсенида галлия n типа
Электроны нижней долины имеют малую эффективную массу m 1 * и высокую подвижность μ 1 . Плотность тока, протекающего через образец, определяется концентрацией электронов в нижней долине n 1 (n 1 = n 0 , где n 0 – равновесная концентрация электронов в полупроводнике):
 . (8.1)
. (8.1)
Увеличим приложенное электрическое поле. С ростом поля возрастает скорость дрейфа электронов. На длине свободного пробега l электроны приобретают энергию eEl , отдавая при столкновениях с фононами кристаллической решетки меньшую энергию. Когда напряженность поля достигает порогового значения E П, появляются электроны, способные переходить в верхнюю долину зоны проводимости.
Дальнейшее увеличение поля приводит к росту концентрации электронов в верхней долине. Переход из нижней долины в верхнюю сопровождается значительным ростом эффективной массы и уменьшением подвижности, что ведет к уменьшению скорости дрейфа. При этом на вольт амперной характеристике образца появляется участок с отрицательным дифференциальным сопротивлением (ОДС) (рис. 8.2).

Рис. 8.2. N образная вольт амперная характеристика: E – электрическое поле, создаваемое приложенной разностью потенциалов; J – плотность тока
Для возникновения отрицательного дифференциального сопротивления необходим одновременный переход большинства электронов из центральной долины в боковую при пороговой напряженности электрического поля (рис. 8.3). Но получить статическую ВАХ, соответствующую сплошной кривой, не удается, так как в кристалле или около невыпрямляющих контактов всегда есть неоднородности, в результате чего возникают локальные напряженности электрического поля, превышающие среднюю напряженность. Превращение в этих местах «легких» электронов в «тяжелые» еще больше увеличивает неоднородность электрического поля. Поэтому практически не получается одновременного перехода большинства электронов в кристалле из центральной долины в боковую и статическая ВАХ остается без участка с ОДС.

Рис. 8.3. Распределение электронов при различных значениях напряженности поля
8.3. Статическая ВАХ арсенида галлия
Получим зависимость скорости дрейфа электронов от поля υ Д (E ) для случая отрицательного дифференциального сопротивления.Продифференцировав уравнение по напряженности электрического поля, получим:
 . (8.2)
. (8.2)
Тогда условие существования отрицательной дифференциальной проводимости можно записать в виде:
 . (8.3)
. (8.3)
Предположим, что распределение электронов между долинами выражается следующим образом:
 , (8.4)
, (8.4)
где k
– константа;  – напряженность поля, при которой
– напряженность поля, при которой  .
.
Обозначим также отношение подвижностей в нижнем и верхнем минимумах как константу:
 . (8.5)
. (8.5)
Предположим, что подвижности μ 1 и μ 2 не зависят от поля и что локальное распределение электронов между минимумами мгновенно следует за изменениями поля как во времени, так и в пространстве. В арсениде галлия, в котором междолинные переходы электронов определяются процессами рассеяния на оптических фононах, эффективное время рассеяния имеет величину 10 -12 сек. Следовательно, для рабочих частот примерно 10 ГГц или ниже междолинные переходы можно считать мгновенными .
Для концентрации n 1 и n 2 можно записать:
 ; (8.6)
; (8.6)
 ,
,
где  .
.
Средняя скорость при данной напряженности поля равна:
На рисунке 8.4 приведена зависимость дрейфовой скорости в зависимости от напряженности электрического поля, рассчитанная по соотношению (8.7) для арсенида галлия.

Рис. 8.4. Зависимость скорости дрейфа от напряженности поля для GaAs
Пороговая напряженность поля E
П, при которой начинается участок ОДС, по экспериментальным данным равна ~3,2 кВ/см. Значение подвижности при низких полях равно ~8000 см 2 /В·с, начальное значение дифференциальной отрицательной подвижности ~2400 см 2 /В·с. Напряженность поля, при которой кончается участок ОДС, приблизительно равна 20 кВ/см.
Электронные температуры (T
e) в обеих долинах будем считать одинаковыми. Тогда, пользуясь статистикой Максвелла – Больцмана, запишем:
 , (8.8)
, (8.8)
где m 1 * , m 2 * – эффективные массы в долинах, n 1 , n 2 – концентрации электронов в долинах, M 2 – число верхних долин, M 1 – число нижних долин.
{GaAs: M
1
= 1, M
2
= 4, m
1 * = 0,067m
0 , m
2 * = 0,55m
0 ,  }.
}.
Теперь имеем:
 ; (8.9)
; (8.9)
 . (8.10)
. (8.10)
Получим выражение для электронной температуры. Воспользуемся условием баланса энергии, приобретаемой электронами в электрическом поле в единицу времени и теряемой в это же время за счет столкновений с фононами :
τ e – время релаксации энергии (~10 -12 с).
 . (8.12)
. (8.12)
На рисунке 8.5 приведена расчетная зависимость дрейфовой скорости электронов в GaAs при различных температурах, иллюстрирующая влияние температурной зависимости подвижности в обоих минимумах.

Рис. 8.5. Зависимость дрейфовой скорости электронов в GaAs от E при T , K :
1 – 200, 2 – 300, 3 – 350. Кривая 4 – заселенность верхней долины при 300 К
8.4. Зарядовые неустойчивости в приборах с отрицательным дифференциальным сопротивлением
Рассмотрим однородно легированный электронный полупроводник с омическими контактами, к которому приложена разность потенциалов (рис. 8.6). Создаваемое в нем электрическое поле будет E = E П. Пусть вследствие тепловой флуктуации группа электронов сместилась в сторону катода относительно неподвижных ионизованных доноров.Возникшая избыточная концентрация электронов должна изменяться во времени в соответствии с соотношением:
 , (8.13)
, (8.13)
представляющим собой закон релаксации основных носителей заряда в полупроводнике.
Если бы в возникшем дипольном домене напряженность электрического поля была меньше E П, то время релаксации Максвелла было бы равно:
 . (8.14)
. (8.14)

Рис. 8.6. Распределение объемного заряда и напряженности поля в образце при формировании домена сильного поля
На самом деле в области возникшего объемного заряда напряженность поля увеличится и станет больше E
П. Следовательно, в выражении для τ
М положительную удельную проводимость нужно заменить на удельную отрицательную дифференциальную проводимость  , где
, где  – отрицательная дифференциальная подвижность, соответствующая участку вольт-амперной характеристики с отрицательной дифференциальной проводимостью. Таким образом,
– отрицательная дифференциальная подвижность, соответствующая участку вольт-амперной характеристики с отрицательной дифференциальной проводимостью. Таким образом,
 . (8.15)
. (8.15)
Из формул для Δn
(t
) и τ
М следует, что в образце с отрицательной дифференциальной проводимостью первоначальная тепловая флуктуация концентрации электронов должна не убывать с ростом t
, а увеличиваться, так как  .
.
Этот факт объясняется следующими обстоятельствами. В области дипольного объемного заряда напряженность электрического поля возрастет и станет больше порогового значения, а в остальной части образца E слегка уменьшится и станет меньше E П, так как напряжение, подаваемое на образец, поддерживается постоянным. В результате этого дрейфовая скорость электронов и плотность тока в области существования объемного заряда уменьшатся, а в остальной части образца изменятся незначительно. Это приведет к дальнейшему увеличению концентрации электронов в левой части объемного заряда (за счет их подтока от катода) и концентрации нескомпенсированных доноров в правой части за счет ухода быстрых электронов от правой границы к аноду. Этот процесс прекратится и дипольный слой достигнет стабильной конфигурации, когда плотность тока внутри и вне его станет одинаковой и будет соответствовать точкам вольт амперной характеристики, лежащим вне участка отрицательной дифференциальной проводимости (например, точкам E = E В и E = E Д) (рис. 8.7).
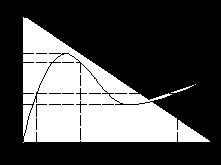
Рис. 8.7. ВАХ диода Ганна
Спад силы тока в цепи при формировании домена сильного поля обусловлен резким уменьшением подвижности электронов в нем и, следовательно, увеличением сопротивления образца. Наиболее стабильное состояние домена соответствует минимальной мощности, потребляемой образцом от источника питания, т.е. когда плотность тока в образце имеет наименьшее возможное значение – J min . Тогда максимальная напряженность поля внутри домена сильного поля будет равняться E Д, а вне его – E В. Ширину или толщину домена (d Д.М.) можно оценить исходя из того, что падение напряжения на образце до и после образования домена одно и то же, т.е.
где исходная напряженность поля E И = E П,
W – длина образца.
 . (8.17)
. (8.17)
Распределение напряженности электрического поля в домене зависит от концентрации электронов в данном образце. При больших n
0 максимум E
располагается в центре домена и зависимость E
от x
имеет симметричный вид. Если n
0 мало, то кривая  принимает форму, близкую к прямоугольному треугольнику.
принимает форму, близкую к прямоугольному треугольнику.
В процессе формирования и после его окончания дипольный домен дрейфует от катода к аноду. Если предположить, что домен возникает у катода за счет неоднородности в распределении примеси, то за время пролета
 , (8.18)
, (8.18)
где  – средняя скорость дрейфа домена, домен достигнет анода и исчезнет. После этого в образце восстановится однородное распределение поля и первоначальное (до формирования домена) значение тока. Затем за счет тепловой флуктуации у катода начнет формироваться следующий домен и т.д. Периодически повторяющиеся процессы формирования домена у катода и рассасывания его у анода приведут к соответствующему изменению сопротивления образца и силы тока.
– средняя скорость дрейфа домена, домен достигнет анода и исчезнет. После этого в образце восстановится однородное распределение поля и первоначальное (до формирования домена) значение тока. Затем за счет тепловой флуктуации у катода начнет формироваться следующий домен и т.д. Периодически повторяющиеся процессы формирования домена у катода и рассасывания его у анода приведут к соответствующему изменению сопротивления образца и силы тока.
Для того, чтобы первоначальная тепловая флуктуация концентрации электронов заметно возросла, необходим интервал времени, превосходящий τ
М. Следовательно, периодическое изменение силы тока через образец будет возникать лишь в том случае, когда  или
или
 . (8.19)
. (8.19)
Это неравенство называют критерием Кремера .
Для арсенида галлия и фосфида индия  см
-2
.
см
-2
.
Режим работы диода Ганна на эффекте междолинного перехода электронов, при котором выполняется неравенство
 см
-2
, (8.20)
см
-2
, (8.20)
называется пролетным режимом. Для его реализации необходимо включить диод в параллельную резонансную цепь, например, в СВЧ генератор с высокой добротностью, настроенный на пролетную частоту ( ). В пролетном режиме на кривой зависимости тока от времени будут наблюдаться резкие всплески, если длина образца значительно превышает ширину домена (рис. 8.8). Для получения формы колебаний тока, близкой к синусоидальной, необходимо уменьшать длину образца или увеличивать ширину домена. Ширину домена можно увеличить, уменьшая концентрацию электронов (n
0) в образце.
). В пролетном режиме на кривой зависимости тока от времени будут наблюдаться резкие всплески, если длина образца значительно превышает ширину домена (рис. 8.8). Для получения формы колебаний тока, близкой к синусоидальной, необходимо уменьшать длину образца или увеличивать ширину домена. Ширину домена можно увеличить, уменьшая концентрацию электронов (n
0) в образце.

Рис. 8.8. Зависимость тока от времени при работе диода Ганна в пролетном режиме
При работе диода в резонаторе к нему кроме постоянного внешнего смещения оказывается приложенным также СВЧ поле, возникающее в резонаторе за счет колебаний тока, протекающего через диод. Предположим, что СВЧ поле меняется во времени по гармоническому закону, а резонатор настроен на частоту выше пролетной ( ). Тогда при достаточно большой амплитуде СВЧ-поля дипольный домен в образце может рассосаться, не доходя до анода. Для этого необходимо, чтобы в полупериод, когда векторы напряженности постоянного и СВЧ-поля противоположны, суммарная напряженность поля была бы меньше E
П, а длительность полупериода была бы больше τ
М, соответствующего положительной подвижности. С точностью до численного коэффициента последнее условие можно записать так:
). Тогда при достаточно большой амплитуде СВЧ-поля дипольный домен в образце может рассосаться, не доходя до анода. Для этого необходимо, чтобы в полупериод, когда векторы напряженности постоянного и СВЧ-поля противоположны, суммарная напряженность поля была бы меньше E
П, а длительность полупериода была бы больше τ
М, соответствующего положительной подвижности. С точностью до численного коэффициента последнее условие можно записать так:  , или
, или
 . (8.21)
. (8.21)
Для GaAs и InP  с/см 3 . Полученное неравенство является условием реализации режима работы диода с подавлением домена. В этом режиме в каждый «положительный» полупериод СВЧ поля в диоде E
>
E
П и у катода зарождается домен, а в каждый «отрицательный» полупериод он рассасывается на пути к аноду. Таким образом, генерация переменного тока в этом случае происходит на частоте, определяемой параметрами резонансной цепи.
с/см 3 . Полученное неравенство является условием реализации режима работы диода с подавлением домена. В этом режиме в каждый «положительный» полупериод СВЧ поля в диоде E
>
E
П и у катода зарождается домен, а в каждый «отрицательный» полупериод он рассасывается на пути к аноду. Таким образом, генерация переменного тока в этом случае происходит на частоте, определяемой параметрами резонансной цепи.
Если обеспечить одновременное выполнение двух неравенств:
 , (8.22)
, (8.22)
то диод Ганна будет работать в режиме ограниченного накопления объемного заряда (ОНОЗ). Для GaAs и InP  с/см 3 . Поскольку в полученном неравенстве период СВЧ сигнала меньше τ
М, соответствующего отрицательной дифференциальной подвижности, то в полупериод, когда
E
> E
П, домен сильного поля не успевает полностью сформироваться, а в следующий полупериод (E
E П) он полностью рассасывается. При этом будет наблюдаться возрастание сопротивления образца в один полупериод СВЧ сигнала и спад его в другой, что вызывает эффективную генерацию мощности на частоте, определяемой параметрами внешней цепи.
с/см 3 . Поскольку в полученном неравенстве период СВЧ сигнала меньше τ
М, соответствующего отрицательной дифференциальной подвижности, то в полупериод, когда
E
> E
П, домен сильного поля не успевает полностью сформироваться, а в следующий полупериод (E
E П) он полностью рассасывается. При этом будет наблюдаться возрастание сопротивления образца в один полупериод СВЧ сигнала и спад его в другой, что вызывает эффективную генерацию мощности на частоте, определяемой параметрами внешней цепи.
8.5. Генерация СВЧ колебаний в диодах Ганна
Как любой генератор СВЧ диапазона, генератор Ганна характеризуется генерируемой мощностью, длиной волны, или частотой генерируемых колебаний, коэффициентом полезного действия, уровнем шумов и другими параметрами.Выходная непрерывная мощность генераторов Ганна в пролетном режиме обычно составляет десятки – сотни милливатт, а при импульсной работе достигает сотен ватт.
Рабочая частота в пролетном режиме обратно пропорциональна длине или толщине высокоомной части кристалла ( ). Связь между генерируемой мощностью и частотой можно представить в виде:
). Связь между генерируемой мощностью и частотой можно представить в виде:
 . (8.23)
. (8.23)
Мощность генерируемых СВЧ-колебаний зависит от полного сопротивления z
или от площади рабочей части высокоомного слоя полупроводника. Приведенное соотношение указывает на то, что ожидаемое изменение мощности с частотой пропорционально  .
.
Верхний предел рабочей частоты диодов Ганна составляет сотни гигагерц (рис. 8.10). Генераторы Ганна из арсенида галлия могут генерировать СВЧ-колебания от 1 до 50 ГГц. Несколько бóльшие частоты получены на генераторах Ганна из фосфида индия в связи с бóльшими значениями максимальных скоростей электронов, но качество приборов из этого материала значительно ниже из-за недостаточной отработки технологии изготовления материала. Преимущество фосфида индия перед арсенидом галлия – большее значение пороговой напряженности электрического поля (10,5 и 3,2 кВ/см соответственно). Это должно позволить создать генератор Ганна с бóльшей выходной мощностью. Для создания бóльших частот генерируемых колебаний представляют интерес тройные соединения GaInSb, так как в них велики дрейфовые скорости электронов.

Рис. 8.10. Примеры характеристик диодов Ганна
Эффект Ганна наблюдается, помимо GaAs и InP, в электронных полупроводниках CdTe, ZnS, InSb, InAs и др., а также в Ge с дырочной проводимостью.
Коэффициент полезного действия генераторов Ганна может быть различным (от 1 до 30 %), так как технологии изготовления приборов и качество исходного полупроводникового материала существенно различаются.
В связи с возможным наличием в кристалле генератора Ганна нескольких неоднородностей зарождение домена может происходить в различные моменты времени на разном расстоянии от анода. Поэтому частота колебаний будет изменяться, т.е. могут возникать частотные шумы. Кроме частотных шумов в генераторах Ганна существуют амплитудные шумы, основной причиной появления которых являются флуктуации в скоростях движения электронов. Обычно амплитудные шумы в генераторах Ганна малы, так как дрейфовая скорость в сильных электрических полях, существующих в этих приборах, насыщена и слабо изменяется при изменении электрического поля.
Важным для практического применения генераторов Ганна является вопрос о возможности их частотной перестройки в достаточно широком диапазоне. Из принципа действия генератора Ганна ясно, что частота его должна слабо зависеть от приложенного напряжения. С увеличением приложенного напряжения несколько возрастает толщина домена, а скорость его движения изменяется незначительно. В результате при изменении напряжения от порогового до пробивного частота колебаний увеличивается всего на десятые доли процента.
Срок службы генераторов Ганна относительно мал, что связано с одновременным воздействием на кристалл полупроводника таких факторов, как сильное электрическое поле и перегрев кристалла из-за выделяющейся в нем мощности.
Генератор на диоде Ганна с междолинным переносом электронов или основан на эффекте Ганна: при приложении к образцу проводника постоянного напряжения больше некоторого порогового значения в цепи источник питания – диод – нагрузка возникают импульсы тока.
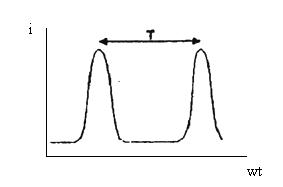
Диод Ганна является двухполюсным полупроводниковым прибором, обладающим динамическим отрицательным сопротивлением в СВЧ-диапазоне, что позволяет использовать его для генерации и усиления электрических колебаний в СВЧ диапазоне. В отличие от всех прочих полупроводниковых приборов, называемых диодами, диод Ганна имеет однородную полупроводниковую структуру без p-n перехода с невыпрямляющими контактами выводов. Его ВАХ, снятая на постоянном токе, подобна характеристикам обычного резистора. Появление отрицательного сопротивления на определённых частотах обусловлено объёмными явлениями, возникающими при высокой напряжённости электрического поля в некоторых полупроводниковых материалах.
Объяснение эффекта Ганна дает квантовая теория. Используются следующие положения:
Все микрочастицы вещества (электроны, ионы, атомы) занимают строго определенные энергетические уровни, при переходе с уровня на уровень эти частицы поглощают или излучают энергию в виде квантов;
Электроны обладают волновыми свойствами, т.е. имеют длину волны
где h – постоянная Планка;
m * - масса движущегося электрона;
V – скорость движения электрона.
Свойства электрона могут быть разными, в зависимости от энергии уровня на котором он находится: m * - эффектная масса и подвижность меняются при изменении уровня.
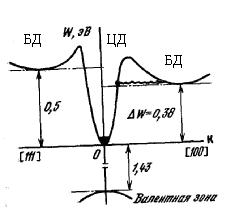
Большинство электронов при нормальной температуре занимают центральную долину (ЦД). m * =0,066m, большая подвижность μ=(6…9)×10 3 см 2 /(В×с). В боковой долине (БД) m * =0,85m, μ=(0,1…0,15)×10 3 см 2 /(В×с).
Наиболее распространённым полупроводником для изготовления диодов Ганна является арсенид галлия. В этом материале электроны в зоне проводимости могут находиться в двух подзонах (долинах). В первой из них, где энергия электронов ниже, они обладают более высокой подвижностью, чем во второй, где энергия электронов высокая. При напряженностях поля ниже критической (Е КР =1,5 – 4 кВ/см) электроны проводимости находятся в нижней долине, и скорость их дрейфа пропорциональна приложенному напряжению.
При Е > Е КР происходит «заброс» электронов в верхнюю долину, где увеличение приложенного напряжения уменьшает подвижность электронов, что равносильно уменьшению тока или увеличению сопротивления этой области, т. е. в данной области имеет место отрицательное сопротивление.
Увеличение сопротивления в этой области приводит к перераспределению падения напряжения вдоль полупроводника. В этой области падение напряжения увеличивается, в остальных участках напряжённость поля падает и становится ниже критического.
Домен сильного поля зарождается возле катода – вывода, присоединённого к отрицательному полюсу внешнего источника напряжения. Зародившись, он сразу же начинает дрейфовать с большой скоростью (около 10 5 м/с) в направлении к аноду, достигнув которого пропадает. При этом напряжённость поля в полупроводниках возрастает, и возле катода зарождается новый домен, и т. д. В результате этих процессов ток, проходящий через полупроводник при напряжениях, создающих поле выше критического, пульсирует (возрастает в моменты исчезновения домена) с периодом, равным времени пробега τ доменом длины кристалла. Значение τ для диодов Ганна из GaAs, в зависимости от расстояния между контактами, составляет 10 -9 – 10 -10 с и менее, что соответствует частотам генерации порядка единиц – десятков ГГц.
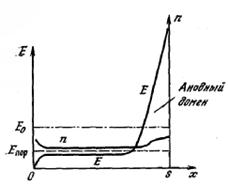
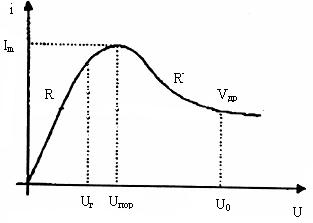
Чем больше пороговое напряжение, тем больше слой накопления, но дрейфовая скорость и ток остаются на том же уровне.
Uг – напряжение гашения домена, при котором он рассасываются.

Период колебаний тока (Т) жестко связан с длиной кристалла d:
Для GaAs V нас ≈10 7 см/с, поэтому рабочая частота таких приборов, которые получили название диодов Ганна, или, как их теперь называют ДПЭ работающих в пролетном режиме, равна f пр =100/d, где f пр получается в гигагерцах, если d выражена в микрометрах; например, при d=10 мкм, f пр =10 ГГц.
Подключая к диоду КЦ, можно создать режимы работы диода Ганна.
1. Пролетный режим - режим генерации, при котором в объеме кристалла возникает и перемещается неоднородность пространственного заряда, содержащая не только слой, обогащенный электронами, но и обедненную область, тесно прилегающую к слою накопления заряда. Режим зависит от нагрузки и частоты настройки.
U 0 >U пор, (U 0 +U г)U пор.
U 0 и R н выбирают из условий выше.
f ген =f пр на эту частоту нужно настроить КЦ.
Данный режим работы неэффективный КПД 1…2%, используется для генерации стандартных сигналов.
2. Режим с гашением домена. При f ген >f пр домен будет рассасываться не доходя до анода, т.к. напряжение на кристалле падает ниже порогового ещё до того, как домен достигнет анода, а при U
U 0 >U пор, (U 0 +U г)U г.
3. Режим с задержкой домена. Если частота генерации f ген меньше пролетной частоты f пр, то образование домена задерживается по отношению к моменту рассасывания.
U 0 и R н выбирают такими, чтобы, (U 0 +U г)
4. Режим с ограниченным накоплением объемного заряда (ОНОЗ). До тех пор, пока U 0 U пор, а это время также определяется периодом свободных колебаний резонансного контура.
(U 0 +U г)U пор





